新闻资讯
金刚石热沉核心是解决极致性能芯片的“散热瓶颈”,主要面向对算力、功耗密度要求极高的高端芯片领域,是突破传统散热方案极限的关键技术之一。 其应用逻辑完全依托于自身不可替代的特性:超高热导率(2000 W/(m·K)以上,是铜的5-6倍和电学绝缘性,可直接与芯片有源区接触,实现高效、无短路风险的“近场散热”。

金刚石热沉
金刚石热沉在微电子芯片中的核心作用
随着微电子技术向更小尺寸、更高频率、更大功率和更高集成度发展,“热管理”已成为制约芯片性能、可靠性和寿命的瓶颈。
热量聚集:芯片单位面积上的功率密度急剧上升,产生大量热量。如果热量不能及时散出,会导致:
- 性能下降:半导体材料的载流子迁移率会随温度升高而降低,导致芯片运行速度变慢。
- 可靠性问题:高温会加速电迁移、介质层击穿等失效机制,缩短芯片寿命。
- 热应力:芯片内部不同材料的热膨胀系数不同,高温下会产生热应力,可能导致器件开裂或脱层。
- “热点”效应:热量在芯片局部区域高度集中,形成远超平均温度的“热点”,对器件是毁灭性的。
传统散热材料的局限:
- 铜、铝等金属:虽然导热性好(~400 W/m·K),但它们的热膨胀系数与半导体材料严重不匹配,直接键合会产生巨大应力。
- 氮化铝、氧化铍等陶瓷:绝缘性好,热导率中等(~200 W/m·K),但仍难以满足下一代超高功率密度的需求。
金刚石作为热沉材料的独特优势
金刚石被誉为“终极散热材料”,其优势主要体现在物理特性上:
热导率:极高,可达 2000 W/m·K。金刚石的核心优势;是目前已知自然界中热导率最高的材料,能极其高效地将热量从“热点”传导出去。
绝缘性:优良的电绝缘体;可以直接作为绝缘热沉与芯片有源区接触,简化器件结构,避免短路。
热膨胀系数:较低,与半导体材料匹配性好;与GaN、GaAs、SiC等宽禁带半导体材料的热膨胀系数更接近,键合后热应力小,可靠性高。
机械性能:硬度最高,耐磨性好;器件坚固耐用。
主要应用场景与价值
高性能计算(HPC)芯片
针对追求极限算力的超级计算机、AI训练芯片等,是金刚石热沉在微电子领域的核心目标场景。
- 高端CPU/GPU:顶尖服务器级CPU和数据中心GPU,在满负载运行时功耗可达数百瓦,传统散热难以快速导出热量。金刚石热沉可作为芯片与散热结构之间的“高效中介”,显著降低芯片结温,保障长期稳定运行。
- AI加速芯片:AI芯片的计算单元高度密集,功耗密度极高,热量集中问题突出。金刚石热沉能精准针对热点区域散热,提升芯片的算力释放效率和使用寿命。
专用集成电路(ASIC)芯片
主要面向对性能和稳定性有特殊要求的定制化芯片。
- 高频通信ASIC:用于5G基站、卫星通信等领域的高频ASIC芯片,工作频率极高,微小的温度波动就可能影响信号稳定性。金刚石热沉可维持芯片温度恒定,保证通信性能。
- 汽车电子ASIC:车载自动驾驶芯片、车规级控制ASIC等,需在-40℃至150℃的宽温环境下工作,且对可靠性要求严苛。金刚石热沉能快速应对芯片瞬时功率波动产生的热量,提升极端环境下的稳定性。
微型化与高密度集成芯片
针对追求体积小型化、功能高度集成的芯片,传统散热方案因体积限制无法应用。
- 微机电系统(MEMS):部分高功率MEMS器件,内部空间狭小,热量难以扩散。金刚石热沉可制成超薄薄膜,贴合在器件表面,实现紧凑空间内的高效散热。
- 三维集成芯片(3DIC):多芯片堆叠的3DIC结构,芯片间热量相互叠加,散热路径复杂。金刚石热沉可嵌入芯片堆叠层间,作为“层间散热通道”,解决堆叠结构的热拥堵问题。
极端环境应用芯片
面向航天、军工等特殊领域的抗恶劣环境芯片。
- 星载芯片:航天器上的导航、通信、探测芯片,处于真空、失重环境,传统对流散热失效,只能依赖热传导。金刚石热沉可高效将芯片热量传导至航天器散热面板,保障在轨设备正常工作。
- 抗辐射芯片:核工业、辐射探测领域的芯片,除散热需求外,还需具备抗辐射能力。金刚石本身具有优异的抗辐射性能,其热沉可同时满足散热与抗辐射双重需求。
金刚石热沉欢迎咨询长春博盛智芯科技,0431-85916189

 高光谱/多光谱成像
高光谱/多光谱成像  光路调节相关
光路调节相关  光学频率梳相关
光学频率梳相关  荧光
荧光  光学组件
光学组件  激光器|光源
激光器|光源 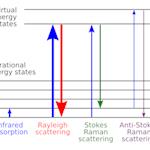 拉曼测量
拉曼测量  Libs激光诱导击穿
Libs激光诱导击穿  显微光谱测量
显微光谱测量  量子效率
量子效率