新闻资讯
多晶金刚石(PCD)在大功率电子器件散热中,是极具潜力的高效散热材料,核心用于解决高功率密度下的散热瓶颈。

多晶金刚石
核心优势:为什么是多晶金刚石?
大功率电子器件工作时会产生大量热量。如果热量不能及时导出,会导致器件温度急剧升高,进而引起性能衰减、可靠性下降甚至永久损坏。因此,散热能力是限制大功率电子器件性能的瓶颈。
多晶金刚石在此场景下拥有无可比拟的优势组合:
超高的热导率:
这是其最核心的优势。天然IIa型单晶金刚石的热导率可达2000-2200 W/(m·K),而CVD法制备的高质量多晶金刚石的热导率也能轻松达到1500-2000 W/(m·K)。这大约是铜的5倍,氮化铝的8-10倍。
优良的电绝缘性:
本征(未掺杂)的多晶金刚石是极好的绝缘体,电阻率极高。这使它可以直接与芯片有源区接触而不会短路,简化了封装设计。
低热膨胀系数:
与半导体材料的热膨胀系数更为匹配,可以减少因温度循环产生的热应力,提高器件的可靠性和寿命。
高击穿场强和高饱和载流子速度:
这意味着它本身也是一种极具潜力的半导体材料,为未来实现“芯-散”一体(同一材料既做电路又做散热)奠定了基础。
具体应用形式与技术方案
多晶金刚石在大功率器件散热中的应用主要有以下几种形式,技术成熟度从高到低排列:
作为独立热沉(热扩散片)
这是最直接、目前应用最广泛的形式。
- 工作原理:将一块独立的多晶金刚石片(热沉)放置在发热的芯片与系统级散热器之间。
- 作用:金刚石热沉的主要功能是“热扩散”。大功率芯片的尺寸很小(毫米甚至微米级),热流密度极高,形成“热点”。金刚石极高的热导率能迅速将点状的热量横向扩散到整个热沉面积上,再高效地传递给上层的散热系统。这相当于把一个尖锐的“热针”变成了一个平坦的“热饼”,极大地降低了热流传输过程中的热阻。
- 应用场景:高功率微波射频放大器(用于5G/6G基站、相控阵雷达)、高功率激光二极管阵列等。
金刚石-on-衬底
这种方式将多晶金刚石与器件原有的衬底材料结合,提升整体散热性能。
- 工作原理:通过晶圆键合或沉积后处理技术,将一层多晶金刚石薄膜与半导体衬底键合在一起。
- 作用:在芯片制造前,就先为它准备一个高导热的“地基”。热量从芯片的有源区产生后,可以立即通过这层金刚石薄膜向下传导,大大降低了从芯片到封装底部的总热阻。
- 典型案例:Diamond-on-SiC。SiC本身是良导热材料(约400 W/(m·K)),但在超高功率下仍显不足。在SiC衬底上集成一层多晶金刚石,可以制造出散热能力极强的衬底,用于下一代超高功率射频和电力电子器件。
器件-first/金刚石键合
这是一种更先进、散热效率更高的集成方案。
- 工作原理:先在常规衬底上制造出半导体器件,然后将器件结构翻转并键合到一块多晶金刚石热沉上,最后移除原有的衬底。
- 作用:这种方式使得发热的器件有源区与金刚石热沉直接接触,热传导路径最短,热阻最小。因为热量不需要再穿过原来的衬底材料。
- 优势:能够实现最佳的散热效果,显著降低芯片结温。
金刚石生长-on-器件(原位沉积)
这是最具挑战性但也是终极的解决方案。
- 工作原理:在制造好的半导体器件表面直接生长一层多晶金刚石薄膜。
- 作用:实现了散热材料与器件的最紧密集成,散热路径极短。
- 技术挑战:金刚石的CVD生长过程通常需要高温(700℃以上)和含氢的等离子体环境,这可能会对已经制造好的精密半导体器件造成损伤。因此,开发低温沉积工艺是该技术能否商业化的关键。
未来趋势是随着CVD技术的进步和成本的下降,多晶金刚石将从目前的高端军事、航天、通信基础设施领域,逐步走向高端消费电子、新能源汽车等更广阔的市场,成为突破下一代大功率电子器件性能瓶颈的“终极散热材料”。
多晶金刚石欢迎咨询长春博盛智芯科技,0431-85916189

 高光谱/多光谱成像
高光谱/多光谱成像  光路调节相关
光路调节相关  光学频率梳相关
光学频率梳相关  荧光
荧光  光学组件
光学组件  激光器|光源
激光器|光源 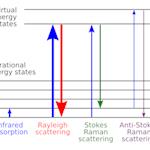 拉曼测量
拉曼测量  Libs激光诱导击穿
Libs激光诱导击穿  显微光谱测量
显微光谱测量  量子效率
量子效率