新闻资讯
金刚石热沉是大功率半导体器件的理想散热方案,能显著提升器件功率密度、可靠性和寿命。

金刚石热沉
为什么大功率半导体器件需要金刚石热沉?
大功率半导体器件在工作时,会因能量转换损耗产生大量热量。随着技术发展,器件特征尺寸不断缩小,功率密度(单位面积产生的热量)急剧上升。高温会带来一系列致命问题:
- 性能下降:载流子迁移率降低,导致开关速度变慢、导通电阻增加。
- 可靠性劣化:结温每升高10-15℃,器件寿命约减半。高温是器件老化、失效的主要原因。
- 效率降低:特别是对于激光器(LED/LD),温度升高会引起“效率骤降”效应,光输出功率大幅下降。
- 系统不稳定:热应力可能导致材料膨胀系数不匹配,引发结构损坏。
传统散热材料的导热能力已接近极限。金刚石凭借其2200 W/(m·K)左右的极高导热率,成为解决这一热管理难题的关键。
金刚石热沉在大功率半导体中的具体应用形式
在实际应用中,金刚石主要通过以下几种形式集成到器件中,每种形式对应不同的技术路线和优势。
作为衬底
这是最直接、最有效的散热方式,将器件的有源区直接制备在金刚石上或通过键合与金刚石紧密结合。
金刚石上生长GaN:
- 工艺:首先在标准衬底上生长GaN外延层,然后通过键合技术将GaN层转移至金刚石衬底,并移除原衬底。或者,采用更先进的技术直接在金刚石上异质外延生长GaN(技术难度极高,但是前沿方向)。
- 优势:热量从GaN有源区(沟道)产生后,仅需穿过极薄的材料即可被下方的金刚石衬底快速导走,热阻极低。
- 应用场景:5G/6G基站射频功率放大器(GaN HEMT)、军用雷达T/R组件。这是当前应用最成功、商业化程度最高的领域之一。
芯片键合:
- 工艺:将制备好的半导体芯片通过共晶焊(使用金锡AuSn等焊料)或低温键合技术,直接倒装焊在预先加工好的金刚石热沉上。
- 优势:工艺相对灵活,可应用于各种类型的芯片。金刚石热沉在此作为高效的“热桥梁”。
- 应用场景:高功率激光器巴条、微波模块。
作为热扩散层
这是目前较为常见和实用的应用形式,尤其在模块级封装中。
- 工艺:将一块薄片状(通常几百微米厚)的金刚石热沉置于发热芯片和宏观散热器之间。
- 功能:金刚石的核心作用不是最终散走热量,而是“均热”。它将芯片局部热点产生的巨大热流迅速在二维平面上扩散开,将“点热源”转化为“面热源”,再传递给后续的散热系统。这避免了热量在芯片下方堆积,显著降低了结温。
- 应用场景:
- 大功率IGBT模块:在新能源汽车、轨道交通的逆变器中,将金刚石热扩散片置于IGBT芯片和铜基板之间。
- CPU/GPU封装:在封装内部,将小块金刚石薄膜置于芯片热点区域上方,进行靶向冷却。
作为复合材料的填充物
这是一种兼顾性能和成本的方案。
- 工艺:将高导热的人造金刚石微粉或纤维作为填充相,与金属或聚合物混合,制成复合材料。
- 材料类型:
- 金刚石/金属复合材料:如金刚石/铜(Diamond/Cu)、金刚石/铝(Diamond/Al)。通过粉末冶金或熔渗法制备,既保持了金刚石的高导热,又利用了金属的易加工性。
- 导热胶/导热膏:将金刚石微粉掺入环氧树脂或硅油中,制成高导热的界面材料(TIM),用于填充芯片和散热器之间的微小空隙,减少接触热阻。
- 应用场景:芯片封装的热界面材料、热管理壳体。
金刚石热沉欢迎咨询长春博盛智芯科技,0431-85916189

 高光谱/多光谱成像
高光谱/多光谱成像  光路调节相关
光路调节相关  光学频率梳相关
光学频率梳相关  荧光
荧光  光学组件
光学组件  激光器|光源
激光器|光源 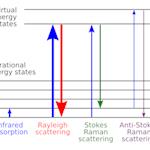 拉曼测量
拉曼测量  Libs激光诱导击穿
Libs激光诱导击穿  显微光谱测量
显微光谱测量  量子效率
量子效率